2019年5月,ASML與三井化學簽署授權合約,將ASML的EUV光罩護膜(EUV pellicle)技術授權給三井生產。ASML是目前唯一進行量產的EUV曝光機供應商。EUV曝光機的量產帶動了新一輪的EUV供應鏈的發展,包含EUV光阻劑、EUV光罩、EUV pellicle等。ASML則扮演了EUV供應鏈領頭羊的角色,各家供應商無不競相開發對應的產品來配合ASML的EUV曝光機的使用。對於EUV pellicle產品已有哪些供應商已經在積極醞釀當中?被ASML欽點授權合作的三井化學是否能因此佔據先機?本文將針對EUV pellicle產業與專利的分析讓讀者了解這個產品的技術發展現況。
近年來,極紫外光(Extreme ultra violet, EUV)微影在半導體產業中,對於縮小半導體元件的尺寸扮演著最關鍵的角色。在目前曝光機的領導廠商ASML以及晶圓製造產業的龍頭Intel、TSMC及Samsung的帶動下,EUV曝光機正式進入了晶圓生產的環節中,連帶推動了與EUV微影相關的周邊技術及產業之發展,像是為了提升EUV光吸收效率而出現的EUV專用光阻劑(photoresist)、EUV曝光機專用的光罩(reticle)、對應EUV專用光罩的光罩盒(reticle pod)、光罩護膜(pellicle)、檢測機台等,許多廠商都想藉著這次的機會在EUV相關供應鏈取得技術及市場上領先的地位。
與前一代的DUV曝光機相比,其曝光光源的波長由193nm縮短到了13.5nm,提升了曝光機的解析度;而因為EUV曝光機光源極易被外界環境所吸收的特性,曝光機內的鏡片組由一系列的透鏡組改為一系列的反射鏡組構成,連帶使光罩以及pellicle必須隨之改變。Pellicle用於遮蓋光罩上的圖樣區,避免汙染物附著於圖樣區造成缺陷。當EUV pellicle操作於250瓦光源下時,每平方公分會產生的5瓦熱量,導致溫度高達680℃以上。因此EUV pellicle除了要降低光源衰退之外,還必須解決如何在接近真空操作環境中的散熱問題。
目前EUV製程採用無pellicle的光罩。由於光罩缺少了pellicle的保護,需要頻繁地對曝光之後的晶圓進行圖樣檢查(print check)。一旦發現圖案缺陷出現,後續光罩的修復、清理甚至是重製光罩都會降低生產速度以及提高生產成本。因此,雖然EUV pellicle技術難度高,但是對於提高生產速度與降低生產成本卻是不可或缺的一環。一般來說,EUV pellicle在曝光數千至一萬片晶圓之後需要被更換一次,而每片EUV pellicle售價將近10萬美金,未來將是一個不容小覷的市場。目前已知在發展EUV pellicle的公司或學術單位1包含ASML、信越化學、三井化學、S&S Technologies以及韓國漢陽大學(下稱主要專利權人)。筆者利用PatentCloud所提供的專利檢索系統,分析主要專利權人的EUV pellicle相關技術。
專利佈局分析



圖三: 主要專利權人EUV pellicle相關專利申請區域分布(依專利家族數計) (Source: app.patentcloud.com) 圖一至圖三分別主要專利權人所申請的EUV pellicle相關專利之數量、優先權年以及申請區域分布。可看出專利數量較多的是ASML、信越化學與三井化學。早在2007年,ASML跟信越化學就已經開始申請相關專利,而S&S Technologies於2017年才開始布局。以申請區域來看,主要布局的國家仍是半導體主要製造區域,包含US、CN、KR、TW、JP、EP等。其中ASML與三井化學大部分專利家族都有透過PCT進行申請,以便後續更廣泛地佈局其他國家。

圖四: 主要專利權人EUV pellicle相關專利技術分布(依專利家族數計) (資料來源: 世博科技顧問, 2021年)圖四為主要專利權人EUV pellicle相關專利的技術分布,主要以四個面向進行分析:結構設計(EUV pellicle structure design)、材料技術(EUV pellicle material)、製造技術(EUV pellicle manufacturing)以及檢測技術(EUV pellicle inspection)。
結構設計(EUV pellicle structure design)
EUV pellicle結構中主要包含兩個部分:透光薄膜(Film)以及框架(Frame)。透光薄膜用於阻擋顆粒進入光罩的圖樣區,也是EUV光穿透的區域。框架(Frame)將透光薄膜支撐在光罩圖樣區的上方。透光薄膜可包含上下兩層保護層(clapping layer),用於強化透光薄膜的結構。在保護層與透光薄膜之間會有一層接著層(adhesive layer),用於接合保護層與透光薄膜。整個透光薄膜最重要的是要達到一定的EUV透光率(transmission rate),降低EUV光被透光薄膜吸收的比例。需要特別留意的是,只有ASML提出了接著層(adhesive layer)的技術,用於黏著保護層與透光薄膜。
此外,EUV pellicle的透光薄膜被EUV光照射時,溫度會超過600℃以上,因此需要具有散熱結構的設計(Heat dispassion structure)。從圖四看出,S&S Tech與漢陽大學在專利佈局上比較著重於散熱結構。
為了降低EUV光的吸收度,透光薄膜的厚度必須做到100奈米以下,在操作時容易破裂,產生的碎片可能會飛到光罩的圖樣區。因此也需要考量如何在結構上進行設計,以避免破裂的碎片飛散(Breakage region)。ASML作為EUV機台開發商,十分了解機台實際操作時可能會發生的狀況,因此也只有ASML在破裂區域設計(Breakage region)有申請相關專利。其他專利權人則著重於pellicle各層基本結構的設計,例如保護層(clapping layer)以及散熱結構(Heat dissipation structure)。
EUV Pellicle的框架(Frame)必須具有類似氣體通道的設計,以達成EUV pellicle內外的壓力平衡(Pressure balance),同時也必須具有類似過濾顆粒的結構設計(Particle filter)以避免顆粒透過氣體通道進入光罩圖樣區。框架與光罩之間需要用接著層(Adhesive layer)進行結合;框架與透光薄膜之間也具有接合結構的設計(Film combining structure)。以上三種設計,只有信越化學與三井化學都有佈局專利,其他專利權人目前沒有看到相關專利申請。
材料技術(EUV pellicle material)
EUV pellicle的透光薄膜(Film)大多採用無機材料,例如石墨烯或是單晶矽薄膜。只有三井化學同時也申請了有機材料(樹脂)所製成的透光薄膜之專利,對於波長13.5nm的光的透過率達到50%以上。
EUV pellicle的框架(Frame)可用金屬或合金,或是玻璃-陶瓷材料。而用於提高透光薄膜的結構強度的保護層(clapping layer)所用的材料較為多樣化,可以是各種材料的多孔層狀結構。黏著層(adhesive layer)可以採用碳化矽膜,主要用於結合保護層與透光薄膜,此一技術僅由由ASML提出專利佈局。
製備方法(EUV pellicle manufacturing)
以無機材料製成的EUV pellicle透光薄膜一般採用化學氣象沉積(Chemical Vapor Deposition, CVD)的方式形成。框架則採用在基材上進行電沉積塗膜的方式製備。之後再將透光薄膜與框架組合在一起(Film & Frame integration)。或是形成多層薄膜之後,再用蝕刻的方式形成中間區域的透光薄膜與周邊的框架。 對於透光薄膜與框架組合技術(Film & Frame integration),信越化學與三井化學有較多的專利佈局。
檢測方法(EUV pellicle inspection)
EUV pellicle的檢測無法採用原有的DUV pellicle的檢測設備,必須使用EUV光進行檢測,因此對應的檢測技術也需要進行改良。在檢測技術,ASML的專利佈局較多,因應其機台實際使用時檢測pellicle的需求。
主要專利權人佈局差異點之專利技術解析
為了使讀者更進一步了解EUV主要專利權人較具有差異點的pellicle技術,筆者從圖四的技術佈局中挑選出每個專利權人與其他專利權人相比具有差異化的技術類別,並對其中專利價值較高或是專利家族數量較多的專利進行解析如下。
ASML – Pellicle材料使用: US9897930B2

ASML的美國專利強調pellicle材料使用經定向奈米碳管薄片經定向奈米碳管(oriented nano-tube sheet 110)以及(oriented nanotubes 120),pellicle的厚度約在20奈米至500奈米之間。由經定向奈米碳管薄片以及經定向奈米碳管所製成的pellicle具有足夠的機械強度,因此不需要上下層表面的支撐件,以提高EUV光的透射率。此外,pellicle中可進一步包含EUV透明材料粒子(EUV transparent material particles 160)分散在奈米碳管薄片中,以增加機械強度。EUV透明材料粒子可為含金屬矽層粒子或金屬鋯粒子,其所產生的熱量可以快速地經由奈米碳管薄片散熱。
ASML – Pellicle破裂區域設計 (Breakage region): US10466585B2
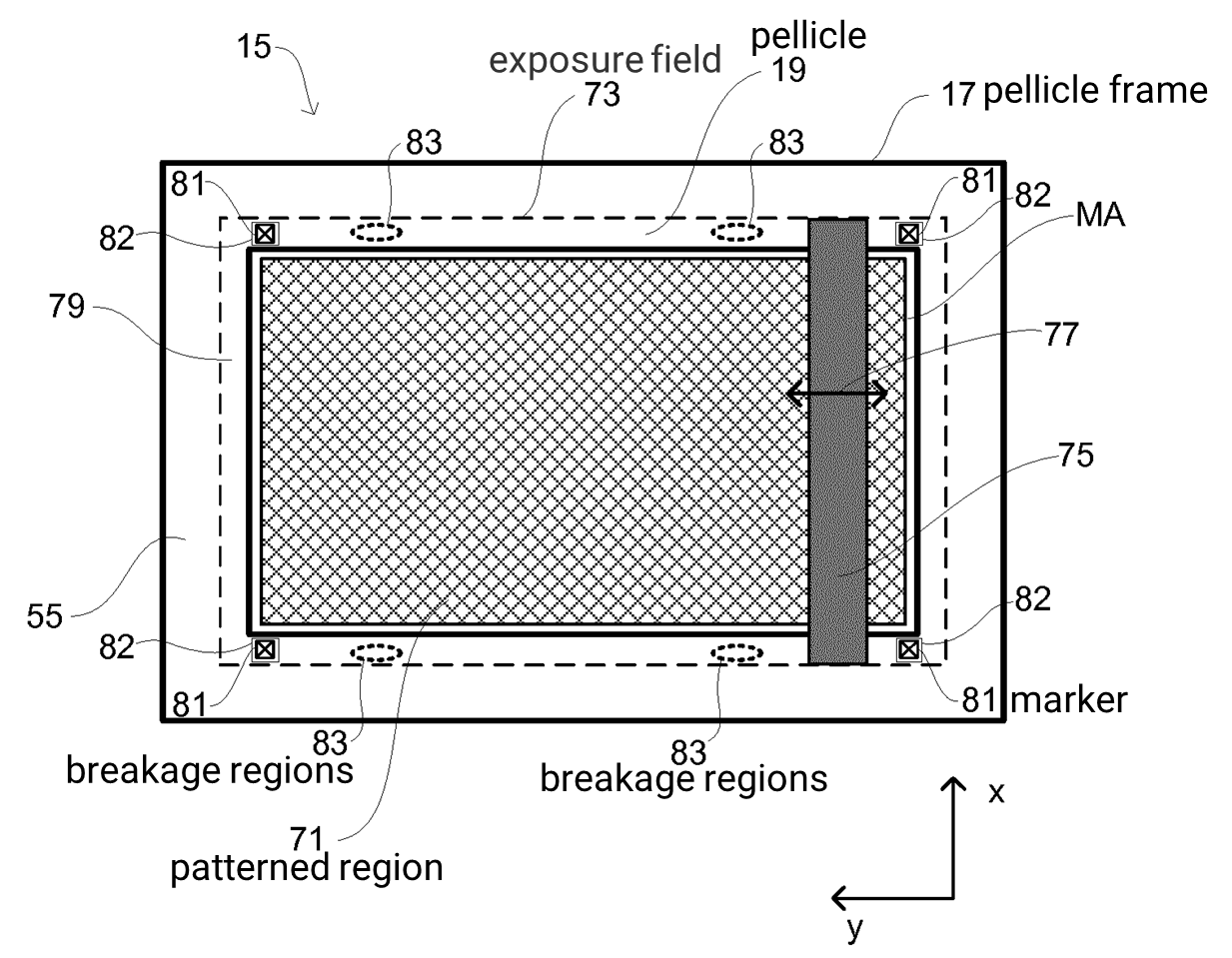
ASML的美國專利US10466585B2強調在pellicle周邊剩餘區域(非直接對應圖樣區patterned region 71)設置多個破裂區域(breakage region 83)。Pellicle由多晶矽製成,厚度約40nm。在破裂區域的厚度比其他區域的厚度小,在曝光設備正常使用時,破裂區域會比其他區域的pellicle優先破裂。破裂區域的配置使得pellicle以受控制的方式破裂,避免pellicle碎片對曝光設備造成汙染。並且,破裂區域的破裂代表pellicle的其餘部分將很快發生故障,透過對破裂區域的監控,可以快速地預測pellicle可能的故障以即時更換新的pellicle。
漢陽大學 – Pellicle散熱結構 (Heat dispassion structure): US20180348626A1
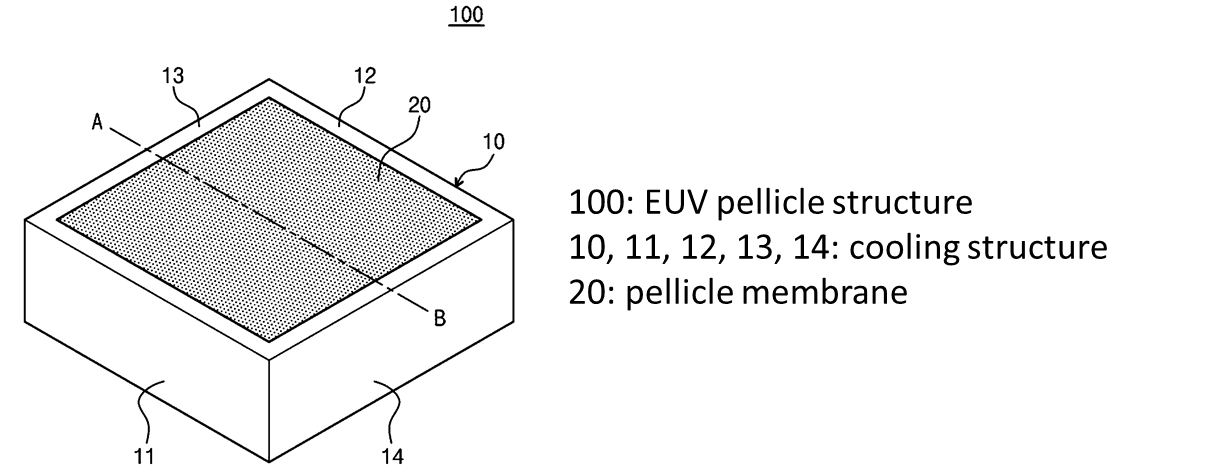
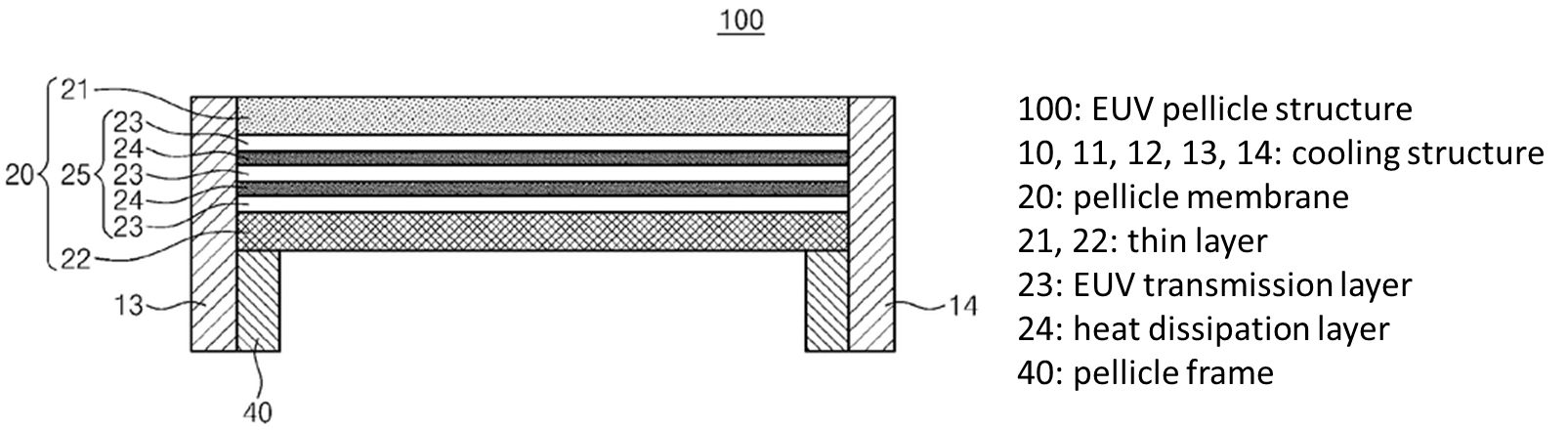
圖七為漢陽大學美國專利US10466585B2中,EUV pellicle的立體示意圖與截面圖。其中,透光薄膜(pellicle membrane 20)中間由多層透光層(EUV transmission layer 23)以及散熱層(heat dissipation layer 24)交替構成,上下再由兩層保護層(thin layer 21, 22)以加強機械結構。透光層由對EUV光吸收係數0.01以下的物質組成,例如多晶矽,厚度約在100nm以下。散熱層由金屬或碳奈米結構組成,厚度約在100nm以下。散熱層可以快速地將pellicle產生的熱量向周圍的冷卻結構(cooling structure 10)傳遞,避免pellicle曝光區受熱變形。
信越化學 – Pellicle壓力平衡 (Pressure balancing): TWI613511B

EUV pellicle與reticle的組裝是在常壓下進行,而在進行曝光操作時則是在真空下進行,因此會需要利用通氣孔進行排氣。同時,通氣孔也可以保持曝光操作時,pellicle與reticle之間的空間與外部空間的壓力平衡,以避免內外壓力差造成pellicle的破裂。在通氣孔必須設置過濾器以過濾外部的顆粒,避免進入曝光區造成汙染。由於pellicle的高度非常低,因此在pellicle框架(組件框架21)的側表面上無法設置面積夠大的通氣孔以及過濾器。信越化學的專利TWI613511B強調用向內挖空通道式的方式設置通氣孔,並使過濾器平行pellicle的表面,以增加通氣孔與過濾器的面積,加強通氣與過濾的效果。
三井化學 – 抑制pellicle熱變形 (Thermal expansion reducing): TWI655497B
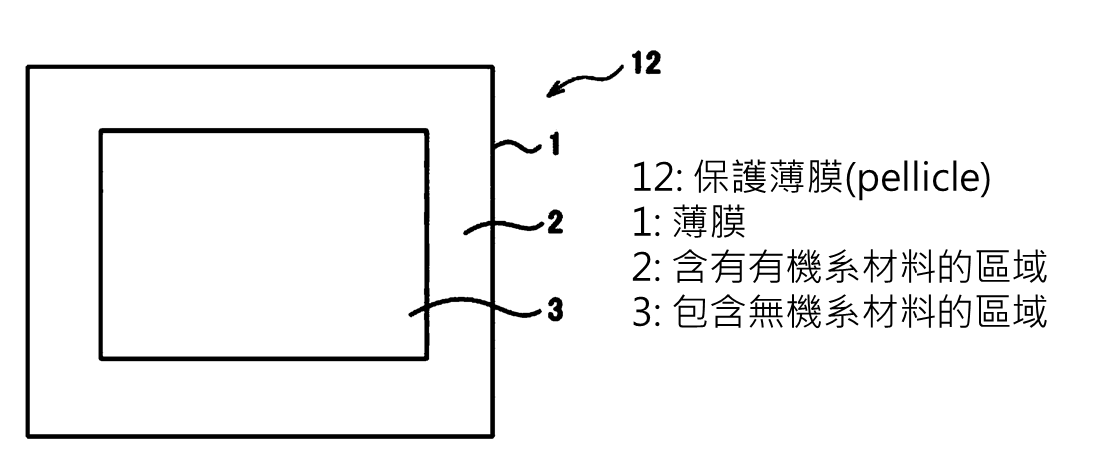
三井化學所採用的pellicle為有機材料與無機材料複合式的薄膜,可抑制pellicle溫度上升而引起的變形。當EUV光照射至pellicle時,pellicle中間無機系材料區域的溫度可達到250℃以上,使pellicle周緣的有機系材料區域達到玻璃轉移溫度,可以防止中間無機系材料區域變形導致破裂。無機系材料例如單晶或多晶石墨;無機系材料例如不會因EUV光照射而產生分解反應的樹脂。
S&S Tech – pellicle 製備方法 (EUV pellicle manufacturing): US20180259845A1
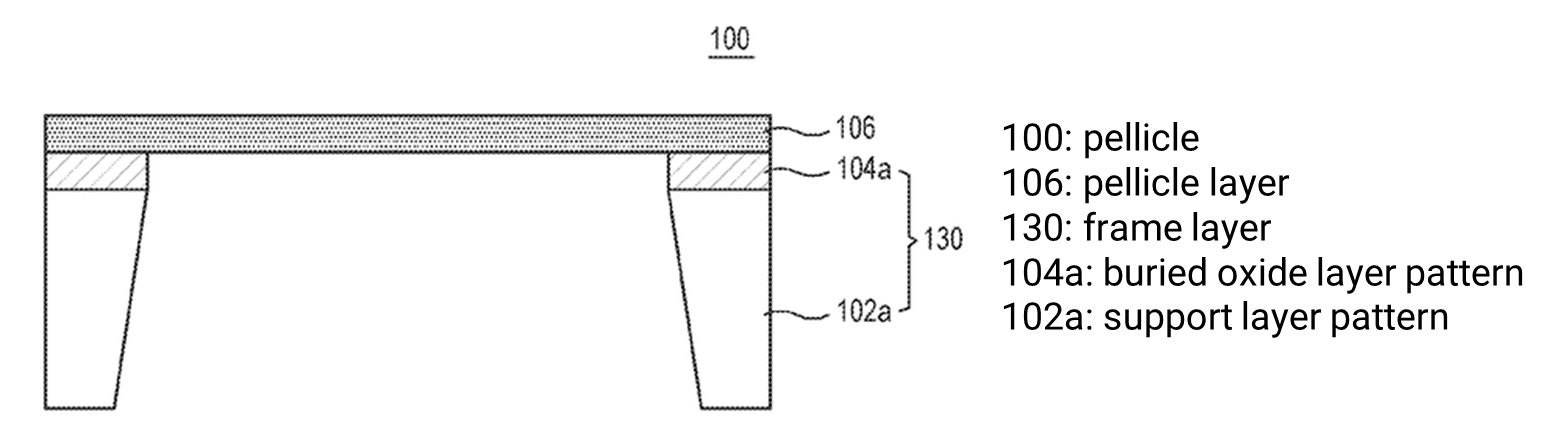
S&S Tech美國專利US20180259845A1中,pellicle的製備是利用蝕刻多層結構的方式形成框架(frame layer)與透明薄膜層(pellicle layer 106)。其中,在框架層與透明薄膜層之間增加埋入式氧化層(buried oxide layer 104),以作為蝕刻停止層,確保不會過度蝕刻(over-etching)破壞透明薄膜層。
小結
由於EUV pellicle需要達到極薄的厚度以確保EUV光的穿透率,同時又要耐受高溫與真空的操作環境,這些因素都是導致EUV pellicle至今尚未量產的原因。以上專利分析可以看出,目前正在發展EUV pellicle的幾家公司都紛紛採用不同的結構或材料,試圖佔據技術領先優勢。獲得ASML青睞的三井化學無疑將得到pellicle在EUV曝光機實際操作時的寶貴經驗,有利於EUV pellicle搭配機台的設計跟應用。由圖四的專利技術分布也可看出,ASML與三井化學的技術分布有互補的效果,例如三井化學填補了ASML在氣壓平衡(Pressure balancing)、黏著層(Adhesive layer)、顆粒過濾裝置(particle filter)、薄膜結合結構(Film combining structure)等技術的專利空缺,或許這也是ASML選中三井化學的原因之一。
隨著採用EUV製程之晶片進入量產,EUV pellicle是進一步擴大EUV製程的重要元件。除了pellicle本體之外,EUV pellicle進入量產使用還需要許多配套的設備與周邊應用,例如pellicle生產設備、材料、檢測機台、儲存盒、安裝工具等等。相關產業的供應商可隨時監控前述技術之專利數據,解析各家技術發展軌跡,並結合自身核心技術,思考合適的切入點,讓自家公司產品也可以搭上EUV供應鏈的列車。
參考出處:
S&S Tech to launch EUV pellicle in Q4
製程材料跳脫摩爾另闢蹊徑 AI掀晶片設計/製造變革
Pellicle, The last piece that completes the EUV Process

